一、確定必要的釬料量
1.確定必要釬料量(體積)的理論依據濱田正和認為:BGA、CSP再流焊接接合部的結構具有下述3個特征。① 凸形再流焊接接合部,不像QFP那樣可以通過外部引線來吸收外部的負荷和應力,BGA、CSP完全靠釬料自身來確保可靠性。② 在BGA、CSP封裝內部也有接合部(見圖1)。因此,受搭載元器件的PCB基板的撓曲變形的影響大,如圖2所示。
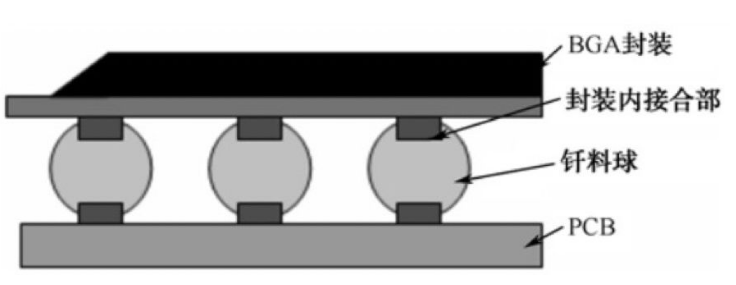
圖1 BGA、CSP封裝及其接合部
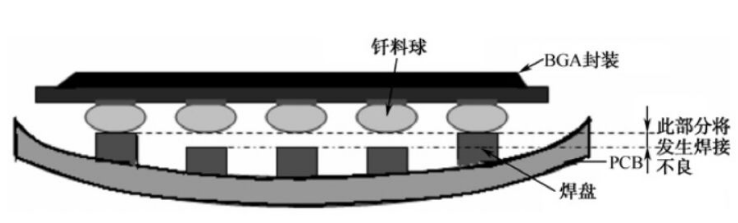
圖2基板撓曲變形的影響
③ 釬料球的接合部均是一次成形的。因此,確保接合部良好的潤濕性非常重要。并利用焊接中自身的矯正作用(由熔融釬料的表面張力對元器件貼裝位置的自動修正效應),來自動修正位置偏差。
為確保BGA、CSP組裝的可靠性,根據什么來配置必要的釬料量呢?BGA、CSP焊前定位所需的釬料量是極少的。因此,必需的釬料量主要是根據PCB的撓曲狀況來確定。應利用基板撓曲的大小和焊接時沉降量的平衡狀態來確定必要的釬料量。沉降現象的發生取決于焊接時接合部熔融釬料的表面張力、釬料球的內壓力及封裝體的自重綜合作用的結果,如圖3所示。
沉降現象發生時,對基板撓曲的吸收示意如圖4所示。

圖3 沉降現象的發生機理
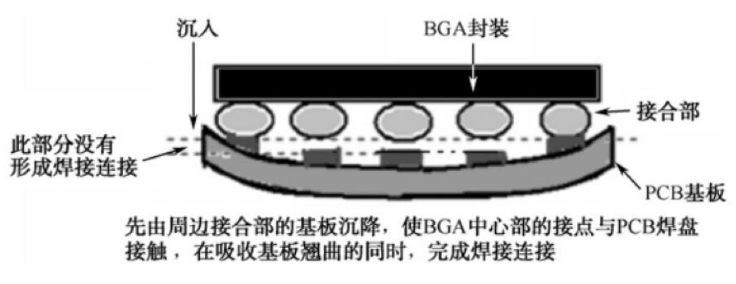
圖4 沉降現象對基板撓曲的吸收
2.必要的釬料量(體積)的確定在BGA、CSP等凸點型接合部所有的外來負荷都必須由釬料本身來吸收,如圖5所示。
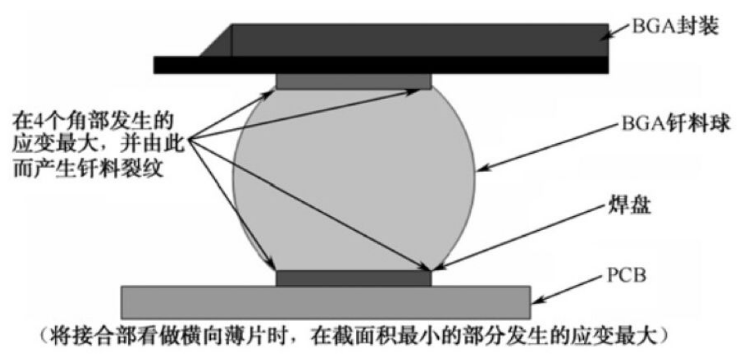
圖5 BGA、CSP等凸點型接合部結構特征
通過對基板撓曲和沉降現象的分析,在確定BGA、CSP焊接過程中發生撓曲的吸收所必需的釬料量時,應從下述兩方面來分析。1)最小釬料量(體積)Qmin當不發生撓曲變形時,為吸收基板撓曲而設置的釬料量就沒有必要了。此時,必要的釬料量只需滿足芯片焊前定位和焊接時的潤濕性即可。
為定位和潤濕焊盤表面,我們設定只要有0.01mm的釬料厚度層即可滿足要求。當PCB焊盤半徑為r時,可求得最小釬料量為Qmin=πD^2×0.01/4(mm3) (1)2)最大釬料量(體積)Qmax當沉降量不能吸收基板的撓曲時,如陶瓷封裝的CBGA、CSP,因為封裝不會撓曲,所以基板的撓曲量-BGA、CSP封裝的撓曲量的差值變大(基板撓曲量-BGA、CSP封裝撓曲量>沉降量)。